如果说电子芯片,是沙子千锤百炼的蜕变;那电子器件封装,是它一展拳脚的筋骨肉身。电子器件封测的成功总是千篇一律,但不成功的封装却总是千奇百怪,话不多说,开始喽!
器件焊线连接芯片和引脚,连接芯片一端,一般为第一焊点(DB 代称),另一端连接金属框架引脚(WB 代称),这两处的焊接性能是封装失效分析重点关注的部分,下面就以此案例,分享一些器件封装失效分析的小知识,小编抛砖引玉,大家相互交流学习。

为了清晰观测到失效位置的内部结构情况,本次元器件分析样品使用飞纳电镜结合离子研磨仪无损抛光的方式,来对位置 1#WB、2#DB,不喷金进行SEM-EDS 以及 SEM-ECCI 分析。

第一焊点失效分析

从第一焊点 DB 截面形状来看,打线的能量很足,金球形变很大,从 EICC 相来看,应力分布在颈部。

扫描电镜下可见金线与焊盘合金化不够理想,合金层不连续,芯片焊盘和金线之间未形成良好的金属间化合物,连接强度势必会收影响,即便短期不出问题,长期抗疲劳情况也较为堪忧。
截面失效分析
再来看 WB 情况,情况更为糟糕,恐怕是直接造成此次器件失效的直接原因。

从切面来看两个焊点完全失效,焊点完全从键合区分离,造成开路失效。扁平的焊球表明熔球温度与键合压力不是故障的主要原因。键合区表面污染,可能是导致键合失效的潜在原因,但扫描电镜图像显示 ball bond 底部极为平整,不像是 ball bond 压到异物之后的形成的形状,而更像是 ball bond 键合后由于某种原因脱离而成。再进一步放大看细节。
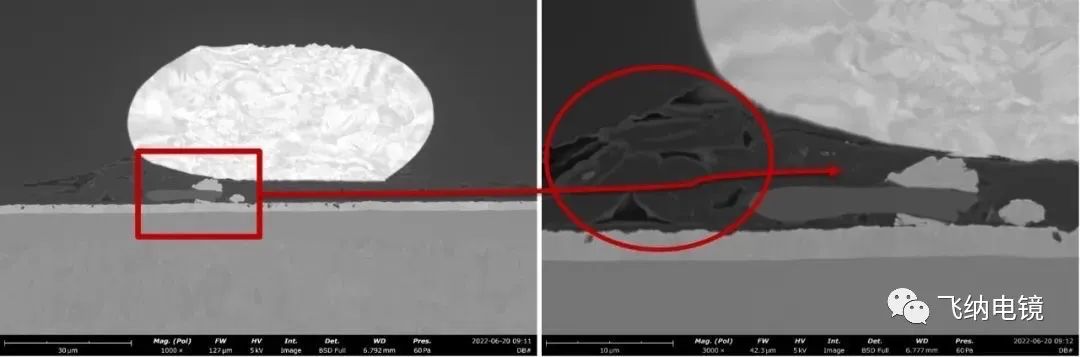
焊盘镀银层有异常凹陷,封装过程中银层脱落碎屑有搬移并填充在引线和焊盘之间,封装胶有疏松堆积。
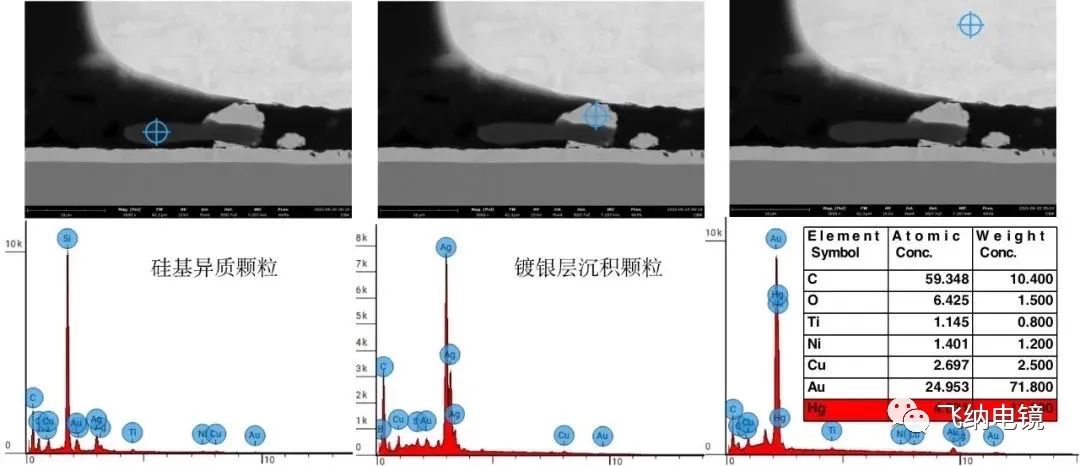
结合能谱结果分析,可以看见封装胶迁移、流动和堆积。而且案例中所选用的金线,EDS 分析含有多种金属,尤其含有微量的有毒重金属汞,推测应为电子垃圾回收金,大家可要擦亮眼睛,这是 RoSH 重点关注的有毒有害金属。
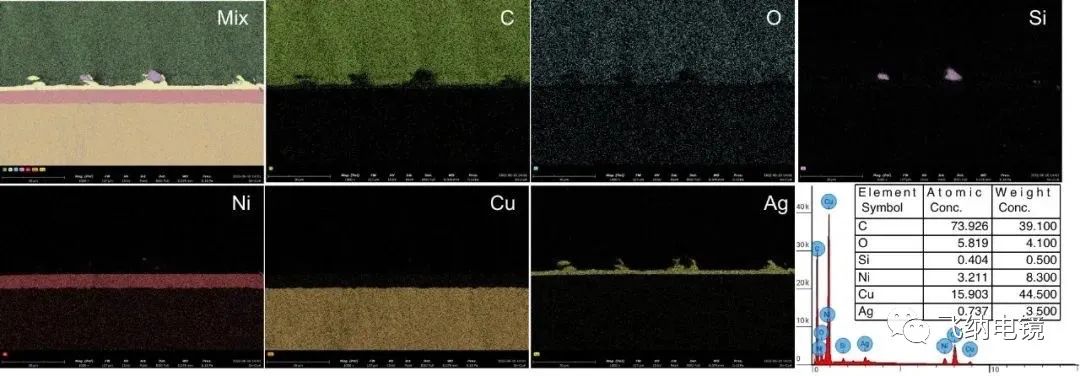
1#WB 截面 EDS 结果
能谱结果发现,铜-镍-银焊盘与封装胶界面能谱分析,银层有很大沉积颗粒,界面还有硅异质颗粒。

焊盘和基板与封装胶严重分离缝隙明显,封装过程中银层脱落碎屑有搬移,封装胶与异物边缘堆积。
以上就是一个元器件封装失效分析的具体案例,结合离子研磨仪的制样方法,使用飞纳电镜(SEM-EDS 联用)对样品进行封装失效分析测试,不仅可以清晰观测失效位置的 SEM 形貌和 ECCI 相,还可以结合能谱结果进一步做综合分析,任何缺陷都将无处藏匿。